



鑽石切割刀
捷科泰亞利用獨家技術所開發生產的鑽石切割刀。
由於作業中不使用水,也不會產生高熱,能在常溫乾燥環境下進行作業,是半導體製造過程中不可或缺的一門技術。
捷科泰亞活用長年累積的鑽石加工經驗,生產各種切割刀,能處理各種類型的晶圓片。
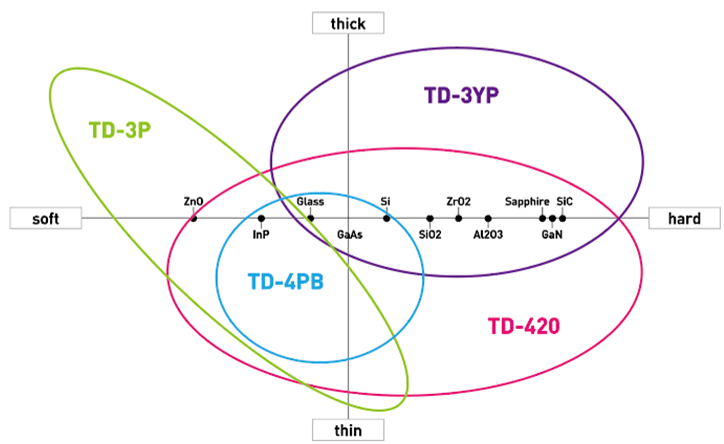 |
TD-3YP
|
TD-3P
|
||
TD-4PB
|
TD-420
|
||
| *有多種角度可供選擇。 |
|
TD-2P
|
TD-8P
|
||
|
*為客製品,訂購時請確認所需角度 |
| 鑽石切割技術因為在作業中不使用水,不會因水溶性的材質 或靜電等和水有關的因素對晶片產生負面影響。 |

鑽石切割的寬度一般只有2~5μm,故可提高每個晶圓片上的晶粒集積率,降低成本。
所謂的鑽石切割,是利用切割時晶片內部所產生的應力原理,將晶粒切割成期望之形狀。
為了能將其裂痕控制的得心應手,必須選擇最適合晶圓片材質的刃口形狀。

切割溝槽形狀(TD-2P) |
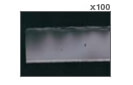
以鑽石切割之晶粒剖面圖
以雷射切割之晶粒剖面圖 |
 02-2955-5135
02-2955-5135
營業時間:8:30-17:30
